以碳化硅(SiC)、氮化镓(GaN)和金刚石为代表的第三/四代半导体具有高热导率、宽禁带等优异特性,已成为新能源汽车、智能电网等战略性产业的关键材料。在半导体器件成本中,晶圆衬底加工占比高达47%。这些材料的超高硬度与脆性导致传统机械切片面临材料损耗大(>40%)、效率低及机械损伤严重等问题,成为制约晶圆制造产业升级的关键瓶颈。激光切片技术为硬脆材料提供了非接触、高精度的新型加工方案,有望将材料损耗降低至10%以下。然而,该技术中激光与材料耦合引发相变并控制裂纹定向扩展的共性物理机制仍未突破,使得工艺优化长期依赖试错和经验,限制了新一代半导体晶圆制造水平的提升。
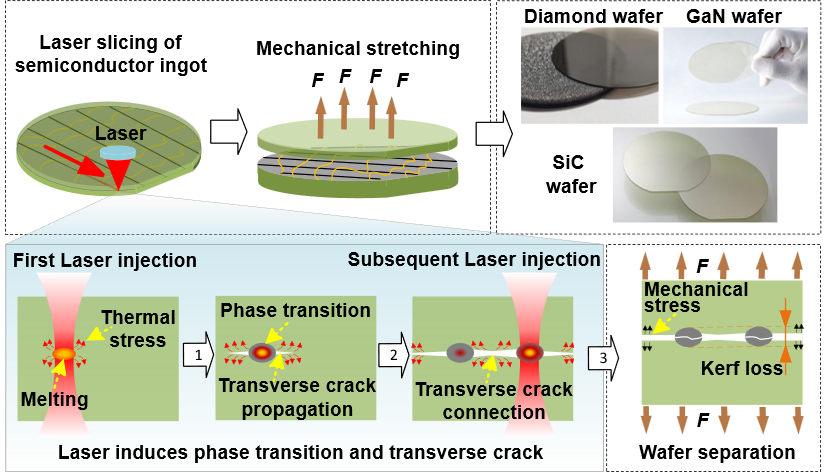
激光切片硬脆半导体晶圆的共性物理机制示意图。
近日,湖南大学机械与运载工程学院张屹教授团队在该领域取得重要进展。通过能量调控实验、分子动力学模拟以及多尺度表征技术,以4H-SiC晶圆为例,首次完整揭示了纳秒激光与4H-SiC相互作用的多阶段相变行为(本征4H-SiC→非晶相变→多型相变),并阐明了激光诱导裂纹生长的动力学机制。
研究发现,相变行为受激光能量阈值调控:能量低于阈值时,改质区以非晶相变为主,裂纹扩展不足;能量超过阈值后,非晶原子流变与局部晶格旋转共同驱动晶格滑移,诱导形成3C-SiC,同时显著提升裂纹扩展速率与切片质量。基于建立的“激光能量-温度场-断裂强度”关联模型,研究首次揭示4H-SiC断裂强度具有显著的能量依赖性。随着激光能量增加,局部晶格温度升高,材料断裂强度逐渐下降;当局部拉应力达到断裂强度时,裂纹开始形核。裂纹在非均匀冷却收缩与尖端应力集中共同驱动下持续扩展,且随冷却进行,其扩展晶面由低指数面向高指数面转变。基于上述机制,该研究实现了对SiC晶圆激光切片过程中相变路径与裂纹动力学的能量调控,建立了物理机制与切片质量的关联。该调控机制可推广至其他硬脆半导体晶圆的激光切片工艺,推动相关制造方法从经验试错向物理机制指导的精准控制转变。
研究成果以“High-quality laser slicing of single-crystal semiconductors guided by energy-dependent phase transition and crack propagation: A 4H-SiC case study”为题发表在机械制造权威学术期刊《国际机床与制造杂志》(International Journal of Machine Tools and Manufacture)2026年第215卷上。湖南大学整车先进设计制造技术全国重点实验室为论文第一完成单位,张屹教授和刘播副教授为论文共同通讯作者,机械院博士研究生卿泽龙为论文第一作者。该工作得到了国家自然科学基金重点支持项目的资助。

基于能量调控实验和分子动力学模拟,揭示了能量依赖的多阶段相变路径和裂纹生长动力学机制,实现了基于物理机制的切片质量调控。
论文链接:https://doi.org/10.1016/j.ijmachtools.2026.104365
来源:机械院
通讯员:曹澳新
责任编辑:周丹